Rigaku launches new line of EUVL tools
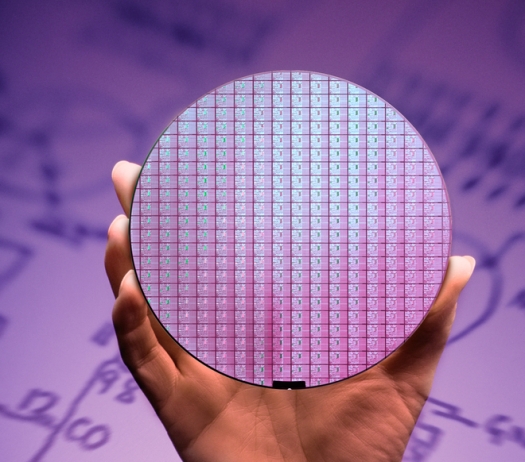
Rigaku Innovative Technologies (RIT) has unveiled its new line of EUVL solutions to support high volume EUV Lithography in conjunction with successful appearances.
During the 2013 International Symposium on Extreme Ultraviolet Lithography in Toyama, Japan, RIT presented its advanced IR Rejection Collector (IRRC) technology for high-power EUV sources. In a standing-room-only reception hosted by RIT at the symposium, the company displayed a full-size version of its IR Rejection Collector Optic.
RIT says it is a fully tested, critical EUVL component with EUV reflectivity of 65 percent for polarised light, 51 percent for unpolarised light, and IR rejection exceeding 99 percent. The IRRC collector optic provided the basis of RIT's oral presentation at the conference on October 10th.
RIT concurrently unveiled its new product line, MaxEUV, which features high-efficiency multilayer optical elements for use with 13.5 nm, 6.x nm and XUV wavelengths in applications including Illumination & Imaging systems. RIT also provided examples of custom multi-layer based mirrors, which are available in any size, shape and wavelength of choice, optimised to meet specific customer requirements.
RIT's presence at the symposium coincides with major announcements for expansion at its Auburn Hills, Michigan facility, which supports world-wide Engineering, Manufacturing and Sales activities.
With over $9 million investment this year in state-of-art multilayer coating & actinic metrology facilities, RIT will continue to position itself as the Industry leader in the next generation of EUV optics deposition and measurement capabilities, as well as the premier provider of EUV Collectors, Illumination and Imaging Optics for lithographic applications.

































